線上影音
Home > ANSYS HFSS 教學 > HFSS 3D Layout端對端解決方案(封裝+PCB+連接器)
本文始於2023年,以2022R2 HFSS 3D Layout示範四種從封裝經PCB到連接器的端對端(end-to-end)模擬手法,比較其模擬差異並說明各自所長。
![]() 2023R1做3D Layout Assembly時的[Place Design]步驟在UI操作行為異常,此問題已在2023R2修復。
2023R1做3D Layout Assembly時的[Place Design]步驟在UI操作行為異常,此問題已在2023R2修復。
-
封裝+PCB+連接器 3D結合 傳統方式直接求解 (方法二)
-
問題與討論
7.1 本文的模擬手法可以搭配[Use Q3D to solve DC point] option嗎?
7.2 本文方法三中,[Mesh Fusion]選[Auto]時,連接器是以哪種網格技術求解的?
參考
![]()
-
BGA封裝(SIwave解)
-
封裝+PCB+連接器 以3DL Assembly連接求解 (方法一)

這是2016年(R17)開發的方法,其概念是把封裝、PCB、連接器都先各自設定好自己的埠與指定求解方式(HFSS/SIwave),最後在HFSS 3D Layout內透過拖曳(或Copy/Paste)+[Place Design]+[Interface]\[Add Interface Ports on Unconnect Pins]+[LNA analysis],得到整個串接的S參數。
其優點是可以PCB板子/BGA封裝用SIwave解,而連接器以HFSS解,最後3DL Assembly就是把這些各別解出的S參數"串接"起來的結果,求解速度快很多,但限制是沒有考慮這三部分彼此間的空間(上下)耦合。
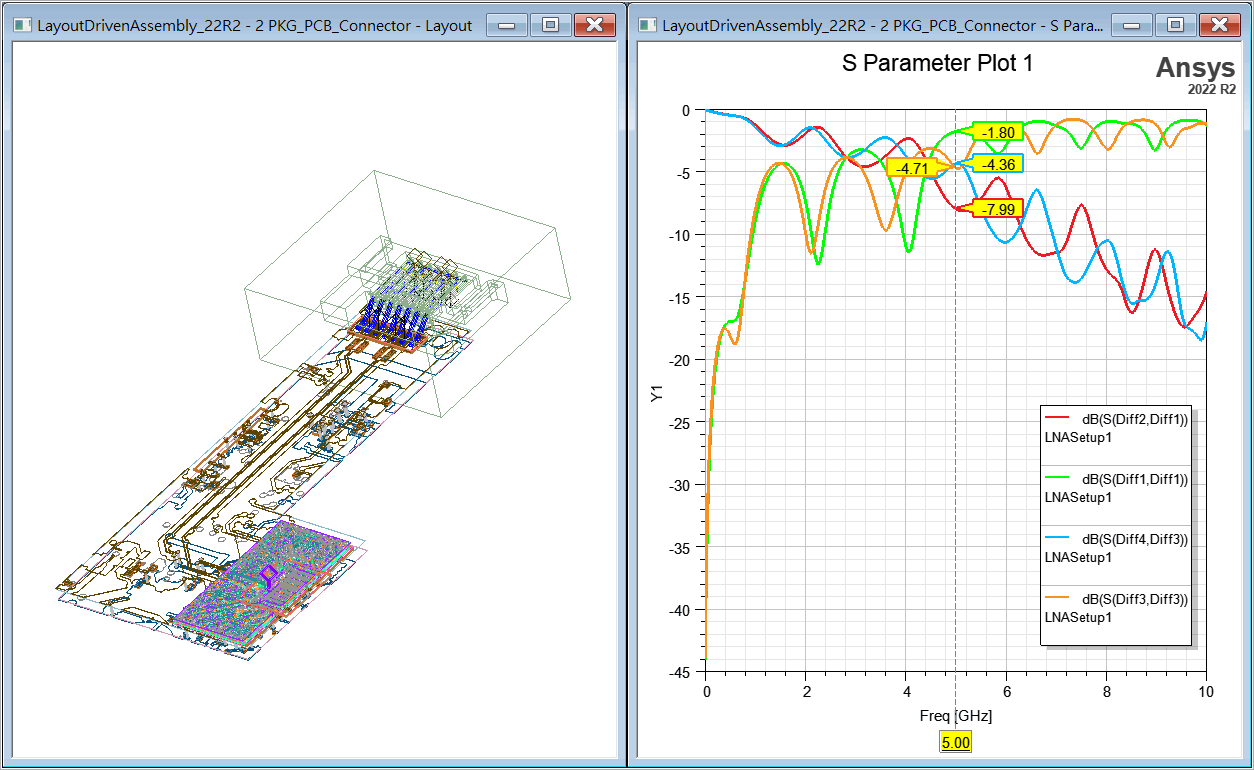
-
封裝+PCB+連接器 3D結合 傳統方式直接求解 (方法二)

這方法是把封裝、PCB、連接器在3DL內全部以HFSS解,有考慮這三部分彼此間的耦合。缺點除了求解時間長、耗用硬體資源多(RAM),還可能會因為結構不同部分的尺寸比差異過大(超過1e+7),導致網格困難,甚至初始網格失敗。
此例在[Design Settings] \ [HFSS Meshing Method] \ 設定[Phi Plus]可以輕易過關,但若以默認的[Phi mesh]或[Classic mesh]解,則會解(卡)很久。
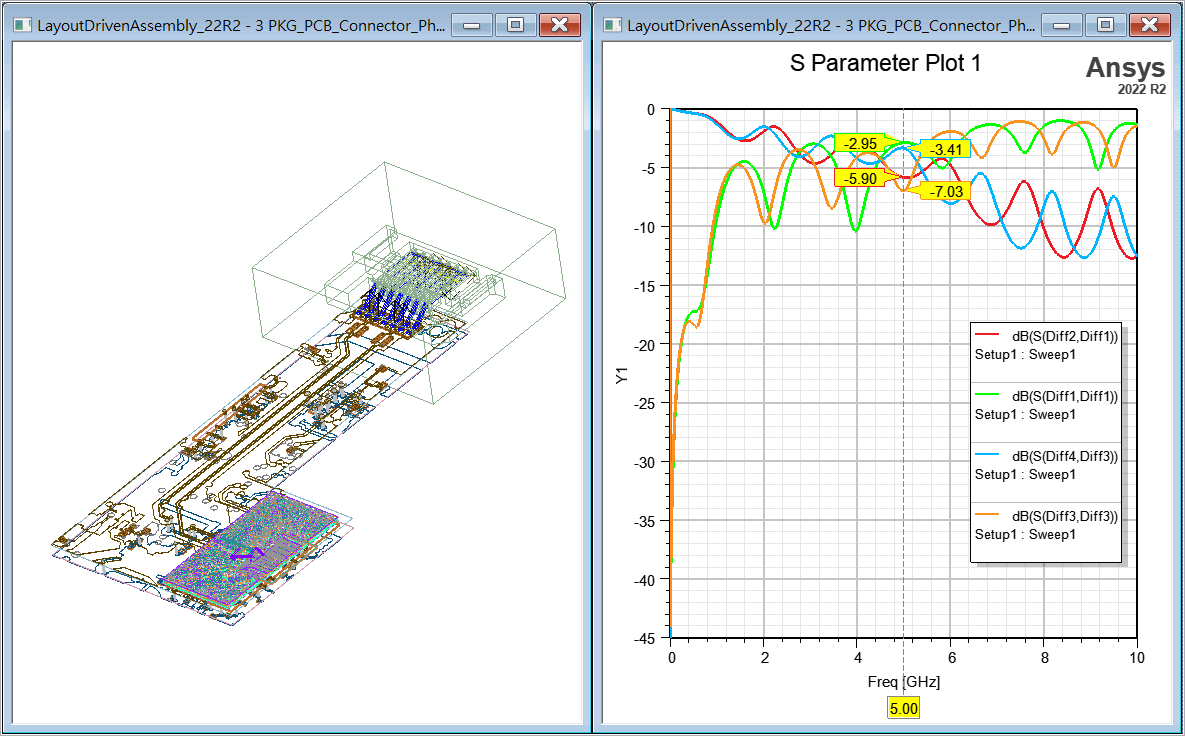
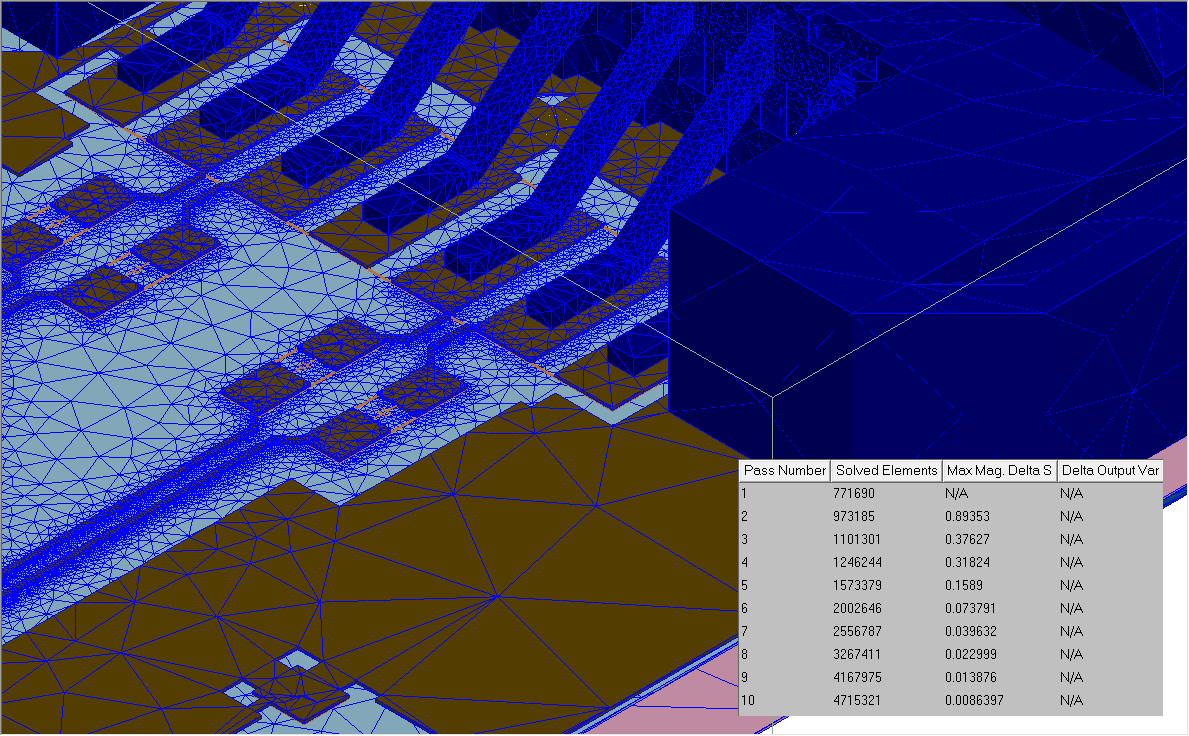
-
封裝+PCB+連接器 3D結合 以Mesh Fusion求解 (方法三)

這方法是把封裝、PCB、連接器在3DL內全部以HFSS搭配[Mesh Fusion]求解,有考慮這三部分彼此間的耦合。連接器以外用HFSS的[Phi mesh]解,而連接器本身以[Mesh Fusion]技術設定[Auto mesh]解。

 在HFSS 3D環境內,對於HFSS 3D設計可以透過[Mesh Fusion]選[TAU]或[Classic] mesh,但在HFSS 3D Layout環境內,對於HFSS 3D設計透過[Mesh Fusion]只有[Phi]或[Classic]可選,沒有[TAU]。
在HFSS 3D環境內,對於HFSS 3D設計可以透過[Mesh Fusion]選[TAU]或[Classic] mesh,但在HFSS 3D Layout環境內,對於HFSS 3D設計透過[Mesh Fusion]只有[Phi]或[Classic]可選,沒有[TAU]。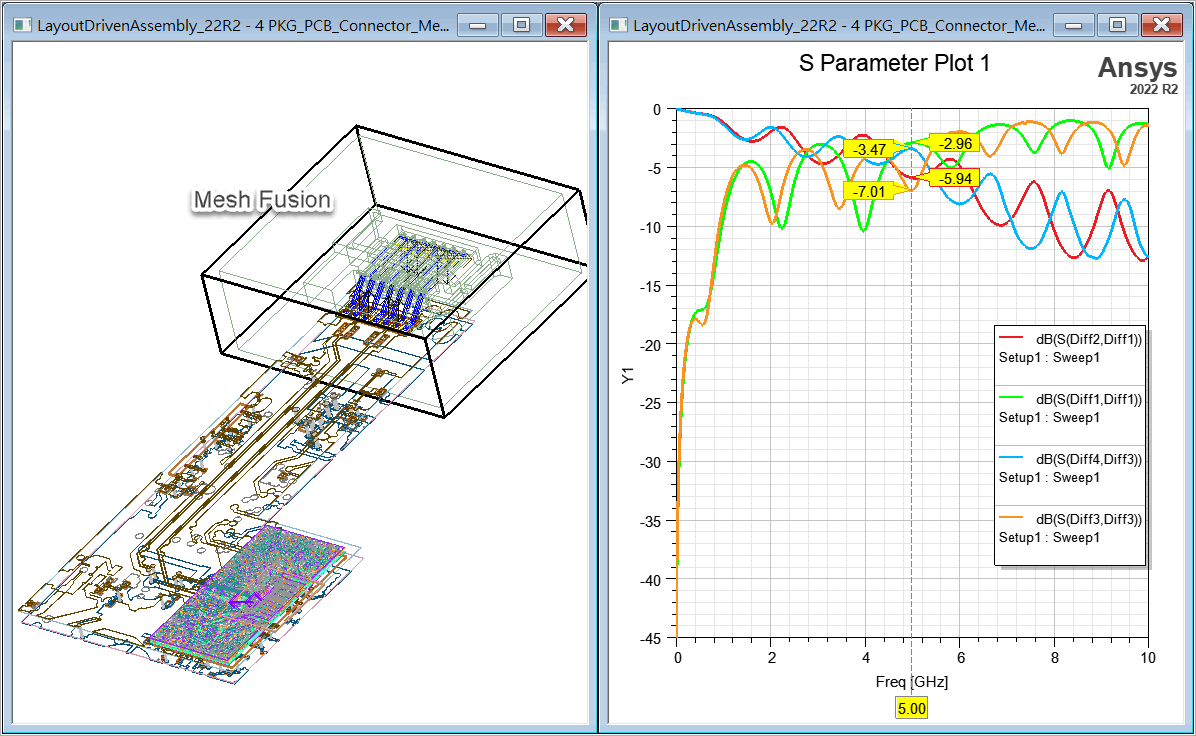

-
封裝+PCB+連接器 以HFSS region+SIwave求解 (方法四)

連接器與連接器下方PCB以HFSS(HFSS region)解,其餘PCB與封裝以SIwave解,有考慮連接器-PCB間與封裝-PCB間的耦合。
訣竅是:一開始PCB與BGA封裝貼合這步驟必須在SIwave內先做好後再輸出到HFSS 3D Layout。如果PCB與BGA封裝貼合這步驟在HFSS 3D Layout內做(如本文方法二、三所示),會發生SIwave solver無法識別DIE端環形的gap port。
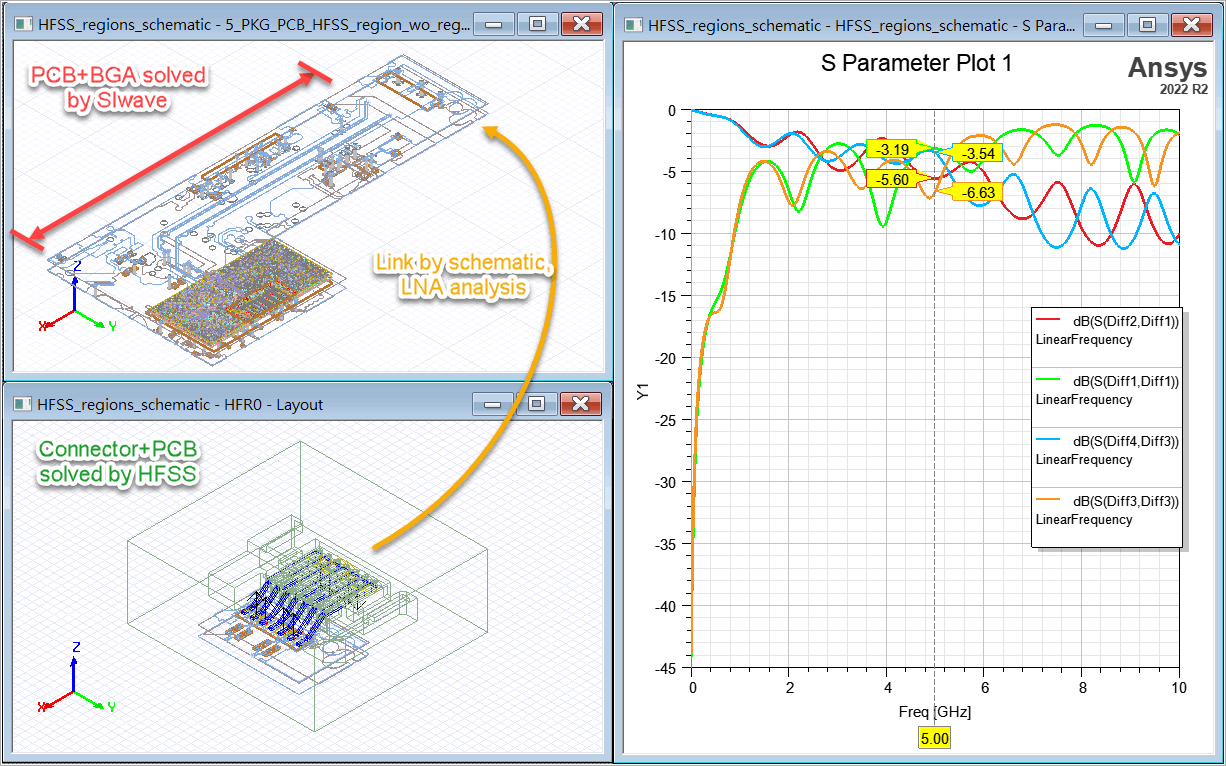
-
方法一 vs. 方法二
方法一不考慮連接器-PCB、封裝-PCB間的耦合,方法二有考慮三部份彼此間的上下耦合。
S參數:0Hz~5GHz差不多(在5GHz約差1~2dB),5G~10GHz則方法二偏較好(在10GHz約差6dB)。
求解時間:方法一以32G RAM/8核心筆記型電腦,全部解完只需要7~8分鐘,而方法二以512G RAM/40核心工作站,全部解完的時間約十幾小時,前者快了百倍速度。
方法二 vs. 方法三
-
問題與討論
7.1 本文的模擬手法可以搭配[Use Q3D to solve DC point] option嗎?

Ans:只有方法一可以搭配使用[compute exact DC point] in SIwave或[Use Q3D to solve DC point] in HFSS 3DL,方法二、三目前(2023)並不支持使用[Use Q3D to solve DC point] in HFSS 3DL。
7.2 本文方法三中(step4),[Mesh Fusion]選[Auto]時,連接器是以哪種網格技術求解的?

Ans:從求解後的profile內容可以看出,是採用Classic mesh。
7.3 封裝、PCB分開求解再串接與真實3D結合建模,後者除了較準,一般結果也較好(smaller loss)嗎?

Ans:是的。本站有另一篇專文"S參數--進階篇",說明這現象背後的原因。
7.4 HFSS含[Mesh Fusion]的求解(方法三)在記憶體耗用與速度都大幅改善,這在所有案例上都成立嗎?

Ans:並非所有的題型都建議使用[Mesh Fusion]。
- 參考
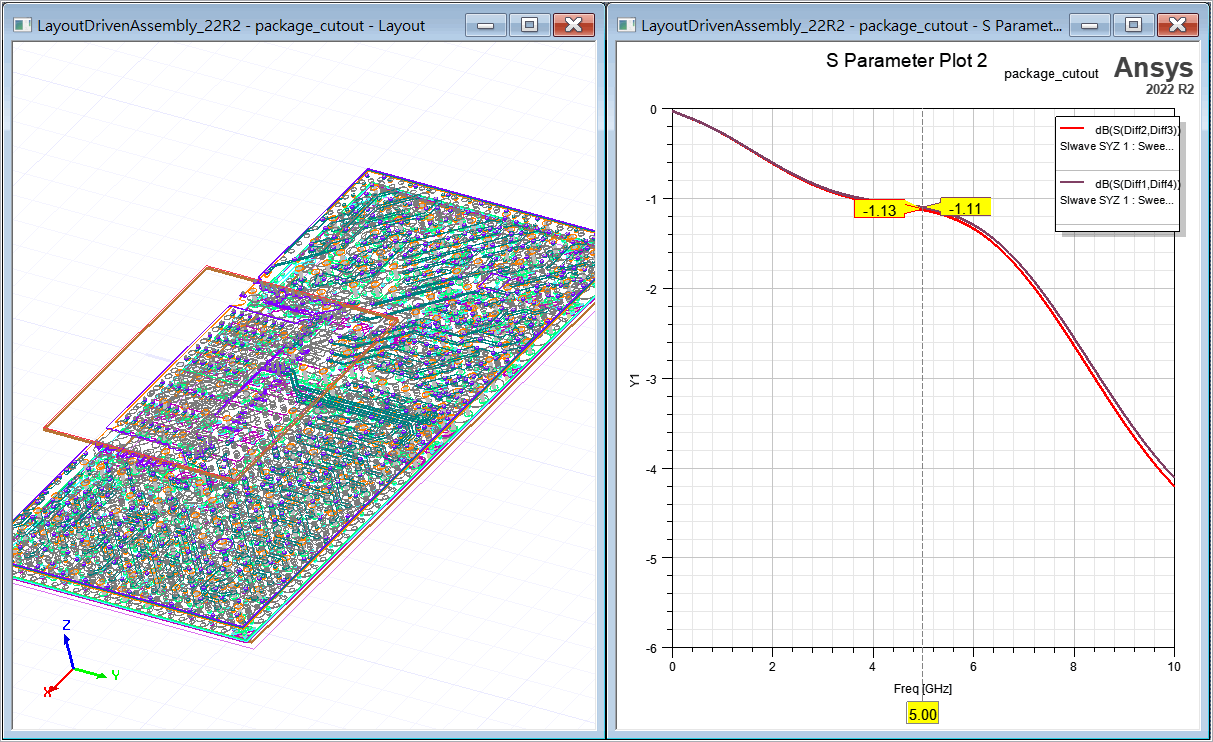
PCB(SIwave解)
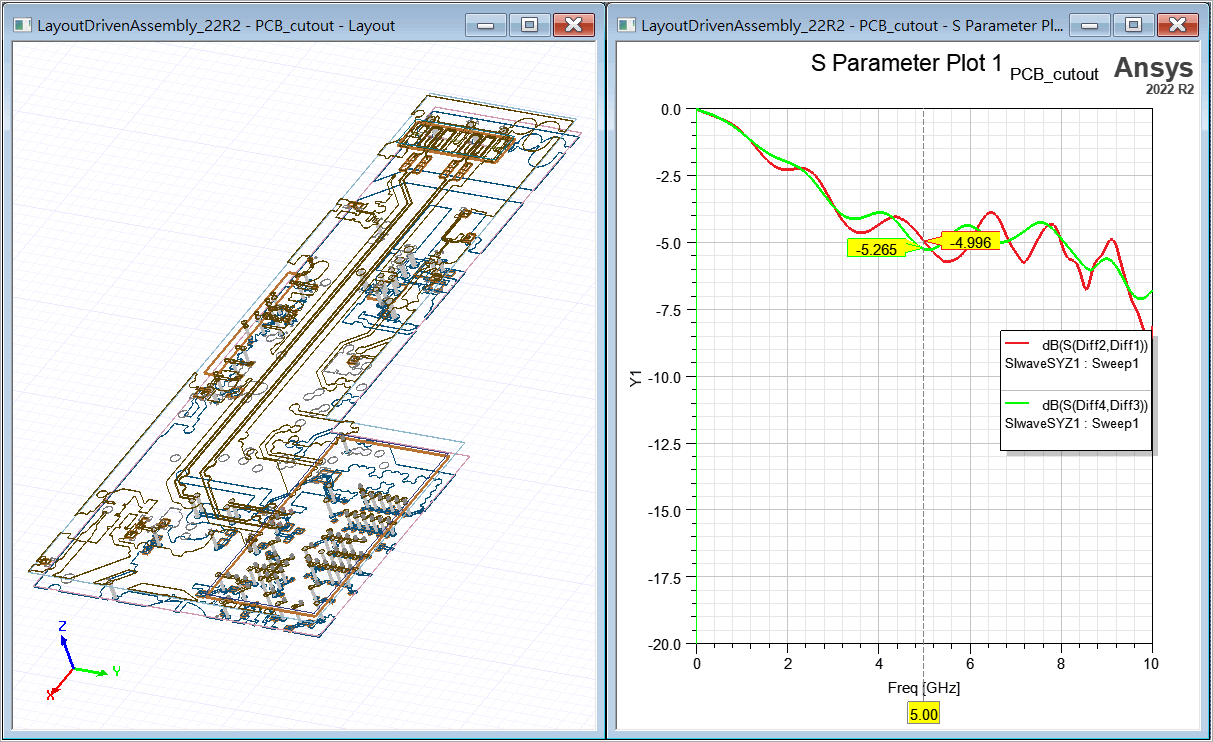
連接器(HFSS解)

如果要把高速傳輸通道的這三部分一起模擬,在HFSS 3DL內該如何做呢?
有四種方法,各有所長,故事繼續看下去 ...
這兩種方法都有考慮三部份彼此間的上下耦合。
S參數:0Hz~10GHz都相同。
求解時間:方法三最終收斂的網格數(last adaptive mesh)330萬,比起方法二最終收斂的網格數470萬,少了30%,整個求解時間則節省約50%。
方法三[Mesh Fusion]是當需要全HFSS求解前提下的最佳選擇。
盡可能使用較新版本的[Mesh Fusion],其解寬頻SI題目的DC region準度會較好。
當有使用[Mesh Fusion]時,不只有refime mesh,連initial mesh都可分散式求解。
方法三 vs. 方法四
這兩種方法都有考慮上下耦合,但方法四由於是SIwave+HFSS協同求解,速度明顯更快(約快40倍)。
S參數:0Hz~5GHz差不多(在5GHz約差0.2~0.4dB),5G~10GHz則方法四偏較好(在10GHz約差2dB)。
求解時間:方法四以64G RAM/8核心筆記型電腦,整個求解時間約十幾分鐘。
方法四是準度與求解時間/耗用資源兼顧的最佳選擇。
[Mesh Fusion]特別適合用於不同區域結構需要不同網格技術的題目。像本文中PCB(ECAD)+連接器(MCAD)的那一端,前者用Phi mesh後者用Classic mesh。(HFSS 3DL內不像Classic HFSS 3D可以跑TAU mesh,所以MCAD題目在3DL內採用Classic mesh)
這也就是為何我們在PCB+Package那端沒有特別採用[Mesh Fusion]的原因。